半導體集成電路的封裝形式從傳統的TO?DIP?SOP?QFP?QFN?PGA?BGA到CSP(芯片級封裝)再到SOC和SiP(系統級封裝),IO數量越來越多,技術指標也越來越先進,隨著摩爾定律越來越接近物理極限,SiP技術成為超越摩爾定律的突破點?SiP是指將不同種類的芯片或元件,通過不同技術,混載于同一封裝之內,由此在一個封裝內可以構建一個系統或子系統?SiP的優勢不僅在于尺寸方面,而且能在更小的空間里集成更多的功能,并縮短設計周期和降低開發成本?在進行高密度系統級封裝產品設計時,除了要對封裝的電學性能和力學性能進行設計分析外,熱學設計已經成為高密度系統級封裝產品設計中越來越重要的環節?本文結合實際工程,利用專業的熱仿真設計軟件對一款大功率高密度系統級封裝產品進行熱分析研究,實現了高效?可靠的大功率高密度SiP產品的熱設計?
1布局設計
大功率高密度SiP產品的熱設計主要由封裝選擇?布局設計?結構設計和材料選擇等部分組成?復雜SiP產品的熱設計需要對每個環節進行合理規劃,并綜合考慮各個環節(包括材料和加工工藝)的合理性,以保證整個SiP產品熱設計的高效性?可靠性和可制造性?基于產品的IO數量和布局需求等因素考慮,本文中設計的大功率高密度SiP產品封裝尺寸為35.00×35.00×5.50(Max)mm,該產品封裝采用7顆芯片和若干阻容器件,各個芯片的尺寸?耗散功率及阻容器件的數量和尺寸等具體信息如表1所示?

綜合考量SiP產品的互連關系和各個芯片之間的功耗等因素,對該SiP產品進行芯片和阻容器件的布局,布局示意圖如圖1所示?基于SOPC芯片?電源芯片和收發器芯片的耗散功率較大,在產品布局時考量各個芯片之間的熱耦合因素,在保證基板互連順暢和滿足可制造性工藝的前提下,盡可能拉大耗散功率比較大的芯片與SOPC芯片之間的布局距離?


2結構設計
基于大功率高密度SiP產品散熱角度考慮,本文中所述產品采用FC-CBGA(陶瓷封裝)的封裝形式(引腳數量1152個),7顆裸芯片全部采用FC工藝進行組裝,并在芯片背面增加金屬蓋增強產品的散熱,該SiP產品的外形示意圖如圖2所示?由于該大功率高密度SiP產品中,裸芯片的最厚尺寸為775μm,遠小于該產品中0805電容的厚度1.25mm,因此在設計散熱蓋板時,為避免蓋板與0805的電容接觸而發生短路,對于散熱蓋板部分區域進行挖空處理,使得散熱蓋板既能與耗散功率大的芯片背面進行接觸來增強散熱(存儲芯片由于耗散功率小,且為了簡化蓋板加工難度,沒有與散熱蓋板直接接觸),又能同時避免與電容接觸而造成短路?
3材料選擇
封裝關鍵原材料由于熱導率等性能參數不一樣,對大功率高密度SiP產品的熱設計影響較大,表2為本文中所述大功率高密度SiP產品封裝關鍵原材料及其性能參數?其中,熱界面材料有三種可供選擇,導熱膠1?導熱膠2和AuSn焊料片,導熱膠1和導熱膠2的熱導率分別為1.92W/mK和4.30W/mK,導熱膠2的熱導率約為導熱膠1的2倍,但其粘結強度為2.8N/mm2,比導熱膠1的粘結強度(3.9N/mm2)較差?AuSn焊料由于其優異的熱導率和粘結強度無疑是熱界面材料的最佳選擇之一,但是采用AuSn焊料不僅需要在芯片背面背金,而且需要較高的工藝組裝溫度(280℃以上),會使得FC芯片和阻容器件互連處發生重融現象,容易造成短路?蓋板材料有兩種可供選擇,Al-SiC蓋板和Cu蓋板,Al-SiC蓋板熱導率為180W/mK,比Cu蓋板熱導率(387.60W/mK)低,但其密度小于Cu的五分之一,能增強器件的板級可靠性?基于產品散熱?成本?可靠性和可制造性等因素綜合考慮,最終確定,熱界面材料選擇導熱膠1,蓋板采用Cu蓋板?

4熱仿真與分析
基于上述幾點分析,對大功率高密度SiP產品建模,并進行仿真分析,該大功率SiP產品的三維模型示意圖如圖3所示?在進行熱仿真前針對該模型設置各個芯片的功耗和設置材料的參數,并對熱仿真模型進行網格劃分,網格劃分質量的好壞,對熱仿真結果的影響較大,該SiP產品對三維模型部分區域的網格進行精細劃分,使得仿真結果更加精確,網格劃分結果如圖4所示?依據JEDEC標準之JESD51系列標準,對該SiP產品進行熱仿真分析,最大總耗散功率為18.546W,其中SOPC芯片運行時最大耗散功率為15W,電源芯片運行時最大耗散功率為2.326W,收發器芯片運行時最大耗散功率為1.12W,存儲芯片運行時最大耗散功率為0.1W,環境溫度為25oC以及相關材料參數如表2所示,仿真結果如圖5和圖6所示,從圖中可以看出,該大功率高密度SiP產品的最大結溫均在電源芯片上,這主要是由于電源芯片運行時單位面積上的耗散功率大(0.167W/mm2)所造成的,通過公式(1)和(2)計算得熱阻RΘJA為7.95oC/W,熱阻RΘJC(Top)為0.57oC/W?

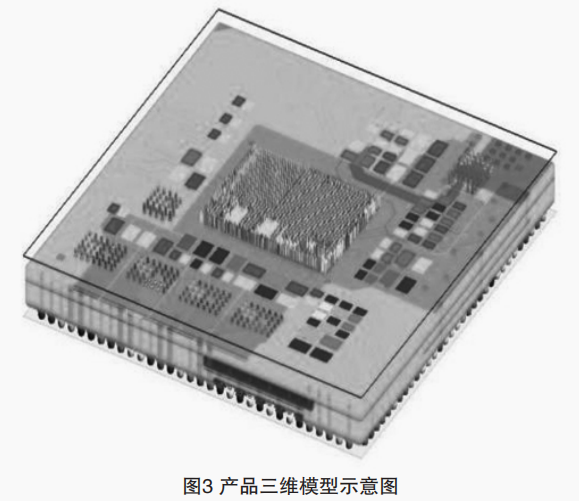


分別對該大功率高密度SiP產品在不同環境中進行熱仿真分析,仿真結果如表3和表4所示,其中表3為該大功率高密度SiP產品在25℃的環境溫度下的熱仿真結果,表4為該大功率高密度SiP產品在85℃的環境溫度下的熱仿真結果?對比表3和表4可以發現在SiP產品增加外置散熱措施(加散熱器和風扇)后,器件的最大結溫和熱阻RΘJA都會隨著外置散熱措施的增強(風速從1m/s增加到4m/s)而不斷下降?相比自然對流情況下的RΘJA,增加外置散熱器和4m/s的風速的情況下RΘJA由原來的7.95oC/W下降到2.11oC/W?表3和表4的結果對比表明,隨著溫度的改變基本上不影響RΘJA(非自然對流)和RΘJC(Top)的值,但是溫度從25℃升高到85℃會使得自然對流情況下的RΘJA由原來的7.95oC/W下降到7.12oC/W?這主要是由于自然對流情況下,空氣的密度?粘度和熱容量隨著溫度的變化而變化較為明顯,并且環境溫度的升高會使得器件表面的溫度升高,從而促進產品的輻射散熱,所以自然對流情況下RΘJA的值隨著溫度的升高而有所下降?此外,由于該大功率高密度SiP產品熱仿真結果為在器件運行最大總耗散功率為18.546W時獲得,在環境溫度為85℃且增加外置散熱措施的情況下器件最大結溫還較高(124℃以上)?基于表3和表4的仿真結果,建議在器件運行總耗散功率為最大時,在考慮周圍運行器件熱耦合的情況下,增加有效的外置散熱措施(加散熱器和風扇)并限制器件運行時的環境溫度?

5結論
本文中完成了一款封裝形式為FC-CBGA1152的大功率高密度SiP產品的熱學設計?分析了該SiP產品熱學設計過程中,需要綜合考慮的各種因素并進行了仿真分析,分析仿真結果可以得出以下結論:大功率高密度SiP產品的最大結溫均在電源芯片上,這主要是由于電源芯片運行時單位面積上的耗散功率大(0.167W/mm2)所造成的;相比自然對流情況下的RΘJA,增加外置散熱器和風扇可以顯著降低熱阻,增強器件的散熱;溫度的改變基本上不影響RΘJA(非自然對流)和RΘJC(Top)的值,但是溫度從25℃升高到85℃會使得自然對流情況下的RΘJA略微降低?由仿真結果建議用戶在器件運行總耗散功率為最大時,在考慮周圍運行器件熱耦合的情況下,增加有效的外置散熱措施(加散熱器和風扇)并限制器件運行時的環境溫度?
本文來源:探索與觀察 版權歸原作者所有,轉載僅供學習交流,如有不適請聯系我們,謝謝。
標簽: 點擊: 評論:
